日本東京科學大學物質理工學院材料系的三宮工教授與日本電子株式會社的安原聰博士、東京大學研究生院資訊理工學系研究科的堀崎遼一教授等人組成的研究團隊,利用掃描穿透電子顯微術(STEM)中同時照射多個電子束的多束技術,成功地以較少的掃描畫素重建出高分辨率圖像。這一成果有望成為推動電子顯微鏡測量實現高速化、低劑量化的新型核心基礎技術。相關成果已發表在《Ultramicroscopy》期刊上。
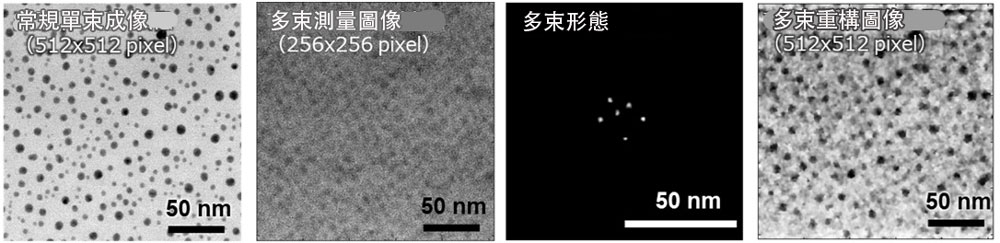
圖1 利用多束技術重新框架金奈米顆粒圖像的示例(供圖:東京科學大學)
傳統的STEM採用逐點掃描模式,成像速度較慢,且電子束會造成樣品損傷,大幅限制了可觀測對象。
此次,研究團隊開發出了一種將同時生成多個電子束的多束照射技術與基於壓縮感知的圖像重新框架相結合的新型掃描穿透電子顯微術技術。具體使用帶有隨機排布多孔結構的光闌生成多束電子探針,通過離焦調控調整電子束分佈,在對樣品施加結構化照明的同時,以較少的採樣採集數據。採集所得信號會得到多束疊加後的低分辨率複合圖像,但通過利用探針形狀資訊,並使用包含全變分正則化的優化演算法進行重新框架,最終還原出超高精細度顯微圖像。
實驗證實,即便採樣密度僅為常規的1/4~1/10,依然能夠成功重新框架金奈米顆粒的圖像。該技術基於不對檢測信號進行空間分解、僅測量信號總量的桶式探測原理,除結構成像外,還可應用於各類分析圖譜的繪製。
該技術能夠顯著緩解電子顯微觀測中長期存在的高分辨率、高速成像、低劑量三者難以兼顧的問題。
原文:《科學新聞》
翻譯:JST客觀日本編輯部
【論文資訊】
期刊:Ultramicroscopy
論文:Compressive multi-beam scanning transmission electron microscopy
DOI:10.1016/j.ultramic.2026.114353