Rigaku Holdings Corporation旗下的株式會社Rigaku(東京都昭島市)宣佈開發出了利用超高解析度X射線顯微鏡對3D快閃記憶體缺陷進行NDI和測量的突破性技術,並憑藉此項研究成果獲得了半導體光刻技術領域最佳論文獎「The Diana Nyyssonen Memorial Best Paper Award」。

左起:獲獎人X射線研究實驗室總經理表和彥(Omote Kazuhiko)以及X射線實驗室先進分析技術研究部成像組的廣瀨雷太(Hirose Raita)(供圖:Rigaku Holdings Corporation、株式會社Rigaku)
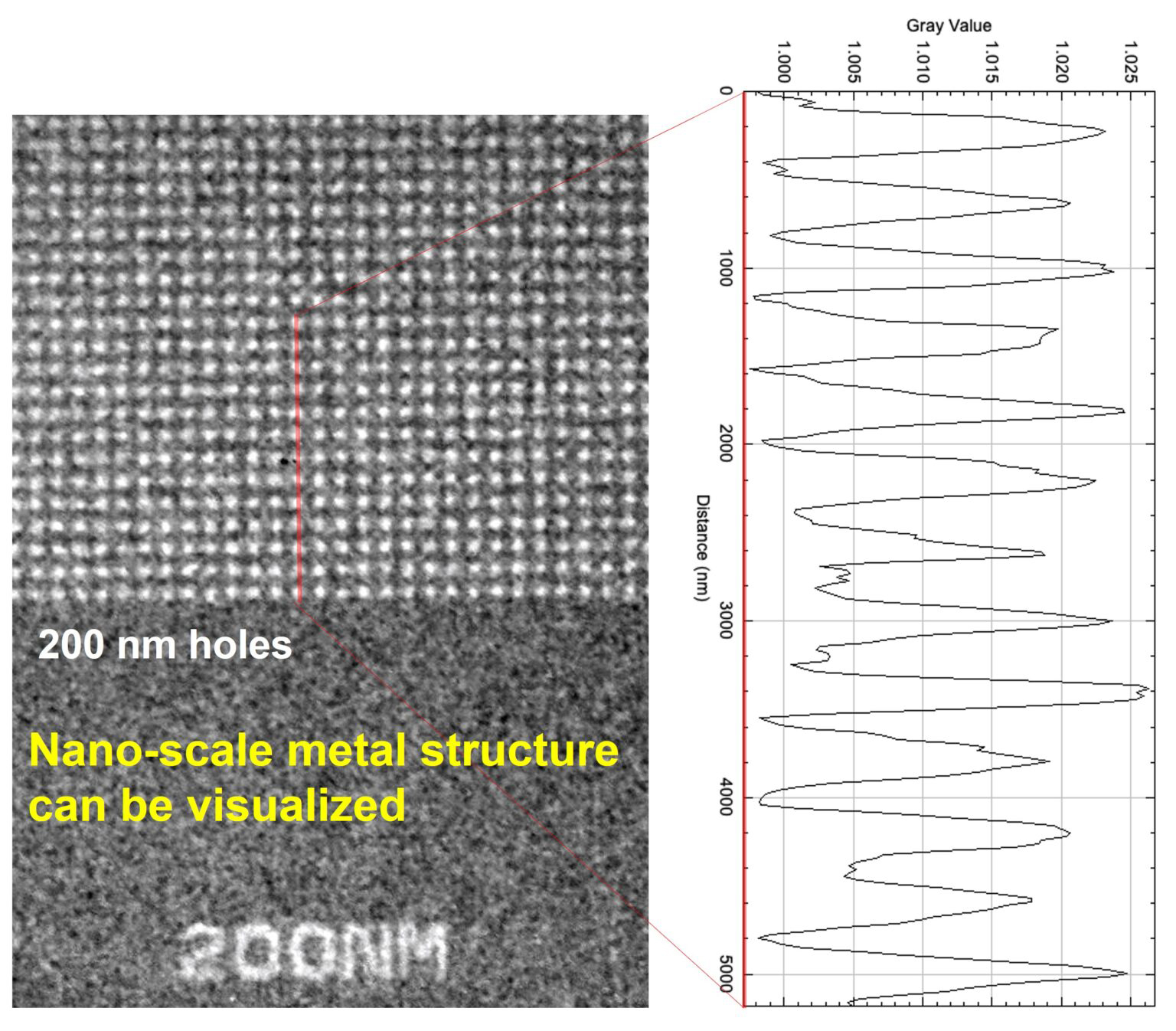
使用該技術檢測和測量的矽片中200奈米級孔圖案(供圖:Rigaku Holdings Corporation、株式會社Rigaku)
該獎項由發佈半導體製造光刻技術領域最新研究成果的國際學術會議「SPIE Advanced Lithography+Patterning Conferences」頒發,授予在測量、檢測與工藝控制領域最優秀的論文。
該獎項是為紀念在光刻技術領域作出重大貢獻的學者Diana Nyyssonen女士而設立,旨在表彰其卓越學術功績。
在3D快閃記憶體製造過程中,對嵌入式金屬結構及被稱為存儲孔的底孔形貌進行檢測與測量一直存在難點。
Rigaku發佈的新技術通過採用X射線檢測,實現了不到光學顯微鏡檢測極限10分之1的超高解析度。該獎項的頒發是為了表彰這一突破性解決方案,它不僅使人們有可能看到奈米級的極小尺寸,而且還能對硅襯底上形成的器件進行無損觀察。
搭載此項技術的設備若應用於3D快閃記憶體產線,將有望提高良品率並優化製造工藝。該公司計劃在2年內完成該技術的設備整合工作。
此外,未來的目標是將該技術應用於更多創新,例如,應用於多層器件連接部位的缺陷檢測與測量等。
【獲獎論文詳情】
標題:Non-Destructive Investigation for Metal Structure in 3D Flash Memory by an Ultra-High Resolution X-ray Microscope
URL:https://rigaku-holdings.com/pdf/Proc.%20of%20SPIE%20Vol.%2012955%20129551B.pdf
原文:《科學新聞》
翻譯:JST客觀日本編輯部













